【導(dǎo)讀】隨著行動裝置影像顯示與畫質(zhì)日漸演進(jìn),行動裝置亦引進(jìn)8K / 4K等高畫質(zhì)的顯示,并應(yīng)用于攝影、游戲和用戶接口,促使影像傳輸帶寬和速度要求大增。更有大尺寸面板也相繼提供高畫質(zhì)面板于電視裝置上,以4K畫質(zhì)而言,其面板的優(yōu)勢和價(jià)值在50吋及以上的電視中更容易體現(xiàn)。日本政府更計(jì)劃于2020年奧運(yùn)期間提供8K高畫質(zhì)的視訊轉(zhuǎn)播。在此規(guī)劃下,面板規(guī)格勢必也得向上提升。隨著邁向高畫質(zhì)紀(jì)元,時(shí)序控制芯片也需提升其所支持的分辨率,處理高畫質(zhì)畫面相關(guān)數(shù)據(jù),進(jìn)而將完美的畫面呈現(xiàn)于面板上。
當(dāng)對畫質(zhì) (Resolution) 的要求愈來愈高,相對需要處理的數(shù)據(jù)量也隨之提升,以4K畫質(zhì)為例,其分辨率是FHD (2K×1K) 的四倍。為了節(jié)省影像傳輸接口的帶寬耗損,因此時(shí)序控制芯片內(nèi)多半會內(nèi)建SRAM內(nèi)存,此一內(nèi)存用來暫存已經(jīng)傳送到時(shí)序控制芯片驅(qū)動器,但尚未要透過時(shí)序控制芯片驅(qū)動器進(jìn)行輸出的影像數(shù)據(jù)。由于面板的尺寸愈來愈高、分辨率愈來愈高、畫面更新率、色澤也都在提升,因此,時(shí)序控制芯片內(nèi)的SRAM內(nèi)存將不斷的加大容量,好因應(yīng)愈來愈大的影像數(shù)據(jù)傳輸量與處理量。
當(dāng)內(nèi)建SRAM容量愈來愈大時(shí),相對時(shí)序控制芯片制造的成本也隨之增加。更多的SRAM內(nèi)存容量就意味著更大的芯片面積。且隨著效能與耗電的要求更加嚴(yán)謹(jǐn),芯片的制程也就愈往高階制程邁進(jìn)。伴隨而來的問題,就是芯片良率以及工作可靠度的影響。先進(jìn)制程與愈來愈大的內(nèi)存需求,成為時(shí)序控制芯片制造端的不穩(wěn)定因素。
為確保時(shí)序控制芯片上的內(nèi)存工作正常,內(nèi)建自我測試技術(shù) (BIST; Built-In Self -Test) 成為芯片實(shí)作中,不可或缺的一部分。自我測試電路 (Built-In Self-Test),可以提高測試的錯(cuò)誤涵蓋率,縮短設(shè)計(jì)周期,增加產(chǎn)品可靠度,并加快產(chǎn)品的上市速度。由于傳統(tǒng)的測試做法是針對單一嵌入式內(nèi)存開發(fā)嵌入式測試電路,所以會導(dǎo)致時(shí)序控制芯片面積過大與測試時(shí)間過久的問題,進(jìn)而增加時(shí)序控制芯片設(shè)計(jì)產(chǎn)生的測試費(fèi)用與銷售成本。另外,傳統(tǒng)內(nèi)存測試方法無法針對一些缺陷類型而彈性選擇內(nèi)存測試的算法,將導(dǎo)致內(nèi)存測試結(jié)果不準(zhǔn)確。有鑒于此,厚翼科技特別開發(fā)「整合性內(nèi)存自我測試電路產(chǎn)生環(huán)境-Brains」,以解決傳統(tǒng)設(shè)計(jì)之不足。本文將針對時(shí)序控制芯片應(yīng)用,結(jié)合厚翼科技所開發(fā)之「整合性內(nèi)存自我測試電路產(chǎn)生環(huán)境-Brains」,搭配實(shí)作案例跟讀者們分享。
實(shí)作案例
以下將以時(shí)序控制芯片應(yīng)用實(shí)作案例,介紹如何透過Brains自動化產(chǎn)生相關(guān)內(nèi)存測試電路,以解決內(nèi)存所造成良率下降問題。此案例所使用的制程為130nm,圖一是該案例簡略架構(gòu)圖,此架構(gòu)明確地將芯片IO部分與主要功能部分切開來,并透過Pin Mux功能,來節(jié)省芯片頂層所需的控制腳位。在主要功能部分,共有四個(gè)Clock Domain,各別Clock Domain下,各自包含了不同種類的內(nèi)存于其中。針對這些內(nèi)存,我們透過Brains自動化的產(chǎn)生相對應(yīng)之內(nèi)存測試電路。
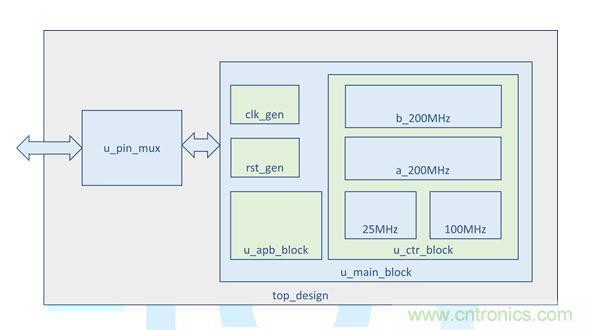
圖一 T-CON案例簡略架構(gòu)圖
此案例中,針對內(nèi)存測試的需求,包含了:全速測試模式 (At-Speed Testing),Bypass功能以及自動分群 (Auto Grouping)。其中的Bypass功能,主要是用來提升DFT Test Coverage。當(dāng)透過Scan Chain做測試時(shí),由于無法觀測到內(nèi)存內(nèi)部數(shù)值,所以整體芯片Test Coverage會受影響。Brains所支持的Bypass功能,即是用來補(bǔ)足此點(diǎn)。該功能將內(nèi)存的輸入端及輸出端進(jìn)行異或處理,并可根據(jù)需求,選擇是否使用緩存器來儲存數(shù)值。藉此,可在Scan Chain測試模式下,提升整體芯片Test Coverage。
由于不同的設(shè)計(jì)項(xiàng)目及應(yīng)用,對于內(nèi)存測試的需求不盡相同。因此,Brains將不同的設(shè)計(jì)需求,以選項(xiàng)的方式呈現(xiàn)。使用者可根據(jù)不同的需求,選擇所需的功能。圖二為Brains功能選擇范例檔案 (Brains Feature List, BFL)。其中紅色框線的部分,即是用來選擇Bypass功能是否要支持。

圖二 Brains功能選擇范例檔案
此案例總共使用到148個(gè)內(nèi)存,其類型包含了Single-Port SRAM,Dual-Port SRAM以及Two-Port SRAM。透過Brains所支持的內(nèi)存自動辨識功能,用戶只需將內(nèi)存模塊的Behavior Model (Verilog file) 指定到Brains中,則可輕易地將設(shè)計(jì)項(xiàng)目中所用到的內(nèi)存模塊辨識出來。再搭配Brains所支持的Clock Tracing功能,從內(nèi)存模塊的Clock訊號,往上層追溯,直到該設(shè)計(jì)項(xiàng)目的Clock Root點(diǎn),即可自動地將內(nèi)存模塊歸類到各自所屬的Clock Domain下。表一為自動分群之后的分群架構(gòu),共有四個(gè)BIST Controller,各別針對其所屬之內(nèi)存模塊來進(jìn)行控制與測試。而詳細(xì)的分群架構(gòu),則會記錄在Brains所產(chǎn)出之BRAINS_memory_spec.meminfo檔案中,該檔案記錄各個(gè)BIST Controller中,關(guān)于Sequencer和Group的架構(gòu),如圖三所示。

表一 內(nèi)存自動分群結(jié)果

圖三 BRAINS_memory_spec.meminfo范例檔案
由圖三可得知,單一Clock Domain下,會包含Controller, Sequencer等架構(gòu),而Sequencer下則會根據(jù)BFL中關(guān)于Group的定義來劃分Group的架構(gòu),相關(guān)設(shè)定如圖四所示。其中sequencer_limit選項(xiàng)用來設(shè)定單一Sequencer下,所支持最多Group數(shù)。而group_limit選項(xiàng)則是用來設(shè)定單一Group下,所支持最多內(nèi)存模塊數(shù)目。

圖四 BFL中Grouping相關(guān)設(shè)定
實(shí)作結(jié)果
當(dāng)Brains執(zhí)行完畢后,則會產(chǎn)生相對應(yīng)檔案。其中包含BIST 電路檔案 (Verilog file) 、相關(guān)合成模擬執(zhí)行檔案 (TCL file) 以及加入BIST電路后的完整設(shè)計(jì)檔案 (Final RTL Design; Verilog file)。圖五為加入BIST電路后,完整的設(shè)計(jì)項(xiàng)目架構(gòu)。
從圖五可得知,此實(shí)作案例最后會由一組JTAG接口,來控制整個(gè)BIST測試的流程。單一JTAG接口的控制方式,可節(jié)省芯片頂層的腳位數(shù)目,且標(biāo)準(zhǔn)JTAG接口,也方便與其它功能整合。
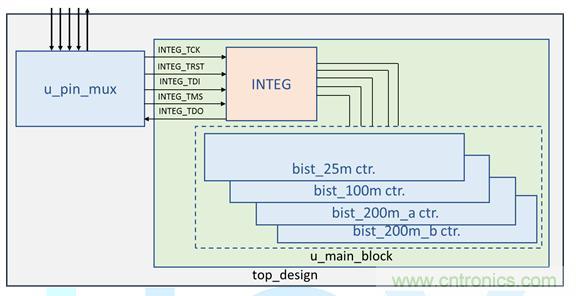
圖五 實(shí)作結(jié)果架構(gòu)圖
當(dāng)相關(guān)電路產(chǎn)生完畢后,需要透過仿真來驗(yàn)證功能性是否完好。Brains除了產(chǎn)生相對應(yīng)的仿真程序外,也會額外產(chǎn)生包含有Fault Bits的預(yù)先埋錯(cuò)內(nèi)存模塊 (Faulty Memory Model)。此預(yù)先埋錯(cuò)內(nèi)存模塊主要用來驗(yàn)證Brains所產(chǎn)生的BIST電路功能正確與否。表二為各個(gè)Clock Domain執(zhí)行模擬驗(yàn)證時(shí)所需花費(fèi)的時(shí)間。
除了仿真時(shí)間之外,所產(chǎn)生的BIST電路面積,通常也是芯片設(shè)計(jì)實(shí)作中,考慮的因素之一。表三為BIST電路合成完之面積結(jié)果,全部的BIST電路占約23K Gate Counts。以此案例之T-CON芯片所含148個(gè)內(nèi)存數(shù)目來比,BIST電路所占之芯片面積相當(dāng)渺小。

表二 模擬時(shí)間結(jié)果

表三 BIST電路面積結(jié)果
總結(jié)
因應(yīng)高畫質(zhì)世代來臨,時(shí)序控制芯片內(nèi)含之內(nèi)存數(shù)量勢必愈來愈多,此時(shí),內(nèi)存測試解決方案亦成為芯片設(shè)計(jì)中不可或缺的一環(huán)。藉由Brains自動化產(chǎn)生相對應(yīng)的內(nèi)存測試電路,對用戶來講,不需太過繁復(fù)的設(shè)定過程,即可完成內(nèi)存測試解決方案的實(shí)作。以此案例為例,單純Brains運(yùn)行的時(shí)間,只需約九分鐘的時(shí)間 (如圖六所示) 就能完成內(nèi)存測試解決方案的實(shí)作。對于分秒必爭的ASIC實(shí)作時(shí)程來說,可節(jié)省相當(dāng)大的時(shí)間。除此之外,Brains彈性的設(shè)定選項(xiàng),以及基于自有專利所建構(gòu)的硬件電路,都是用戶在實(shí)作內(nèi)存測試解決方案的一大利器。

圖六 Brains實(shí)作時(shí)間信息
推薦閱讀:







